Měření morfologie
Měření tvaru povrchu a následně vyhodnocení délkových rozměrů je stále nejčastějším požadavkem na měření s vysokým
rozlišením. Metody nanometrologie zde nalézají využití v mikroelektronice, optice, biologii, analýze částic a mnoha dalších oborech.
Nejčastějším zařízením pro taková měření je mikroskop atomárních sil (AFM), který
nám umožňuje získat data reprezentující morfologii povrchů až s atomárním rozlišením na rozsahu typicky 0,1 x 0,1 mm (ve
speciálních zařízeních i podstatně vyšším). Pro měření 3D struktur
je možné použít nanoCMM (souřadnicový měřicí stroj). Morfologii je pochopitelně možné měřit i jinými metodami,
jako jsou konfokální nebo elektronová mikroskopie, tyto přístupy jsou nicméně z pohledu návaznosti a metrologie
obecně zatím méně rozvinuté než zařízení na dotykovém principu, mezi něž můžeme AFM počítat. I v těchto směrech však
zaznamenáváme překotný vývoj a v budoucnosti bude zejména elektronová mikroskopie pro účely metrologie stále důležitější.
Hlavním kritériem volby mezi AFM a souřadnicovým strojem je tvar měřené struktury. AFM je možné využít
jen pro rovinné struktury, s omezeným rozsahem ve výšce (u komerčních systémů do cca 10 µm).
Data získaná z mikroskopu je možné dále zpracovávat a kromě odměřování rozměrů získat
různé informace o tvaru povrchu: drsnost, vlnitost, velikost zrn či částic, rozložení výšek a sklonů, fraktální vlastnosti a podobně.
Z pohledu metrologie je však nutné při takové analýze dat porozumět způsobu, jakým se výsledek generuje, a správně stanovit
jeho nejistotu, což nemusí být snadné (např. při fraktální analýze). Zpracování dat z měření morfologie v nano- a mikroměřítku
je proto jednou z oblastí výzkumu v oboru nanometrologie. Volně šiřitelný program Gwyddion je jednou z cest,
jak provádět zpracování dat způsobem, který by nebyl jen černou skříňkou. |
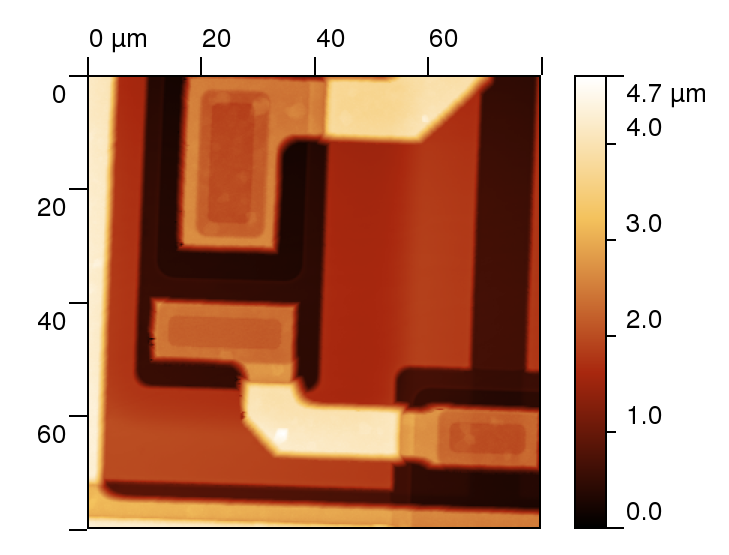 |
| AFM snímek povrchu mikroelektronického prvku |
Pro zajištění návaznosti při měření tvaru povrchu je možné využít dvě cesty:
- kalibrace mikroskopu nebo souřadnicového stroje pomocí vzorků se známými rozměry,
- využití senzorů s návazností (např. interferometrů) přímo v měřicím zařízení.
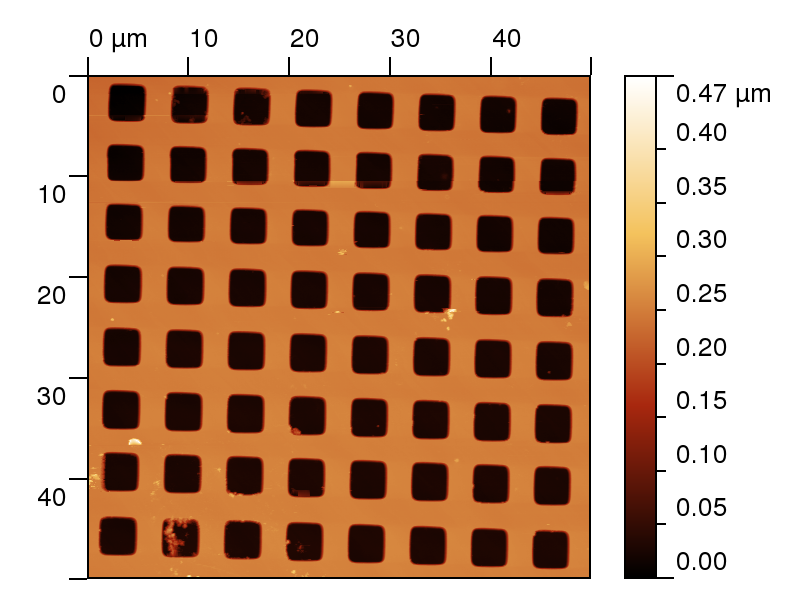 |
Využití kalibračních vzorků umožňuje v kombinaci s komerčními měřicími zařízením dosáhnout přesnosti v řádu desetin procenta,
což zdaleka nemusí být dostatečné (i tak je to podstatně lepší než přesnost komerčních zařízení bez kalibrace, která se pohybuje
v jednotkách procent). Pro dosažení menší nejistoty se v metrologických institutech upřednostňuje druhý přístup, který
ovšem vyžaduje stavbu specializovaných zařízení. Specializované metrologické mikroskopy tak v Evropě najdeme v metrologických institutech
ve většině rozvinutých zemí.
Nejistota měření délkových rozměrů v metrologických institutech se pohybuje typicky v jednotkách nanometru, v závislosti na tvaru měřené struktury.
|
| AFM snímek kalibrační mřížky |
Na našem oddělení se věnujeme vývoji metod pro statistickou analýzu drsnosti
povrchů a vyhodnocení nejistot při tomto typu zpracování AFM dat. Vyvíjíme
také mikroskopy pro měření morfologie na velkých plochách a pro měření s velmi
nízkou nejistotou, a s tím související nástroje pro zpracování dat a výpočty
nejistot.
|

